闪存芯片NAND FLASH的封装
随着目前产品小型化的需求越来越多,且可穿戴设备的逐渐普及,工程师们对于芯片小型化的需求也越来越强烈,这个就涉及到了芯片的封装工艺。这次,我们只针对NAND flash的封装进行介绍。
芯片常用封装有:DIP、QFP、PFP、PGA、BGA、TSOP、COB等封装。这里主要介绍NAND FLASH常用的三种封装(TSOP、BGA、COB)。

1.TSOP封装
TSOP是“Thin Small Outline Package”的缩写,意思是薄型小尺寸封装。TSOP内存是在芯片的周围做出引脚,采用SMT技术(表面安装技术)附着在PCB板的表面,装配高度不到1.27mm。具体到FLASH这类型芯,工艺主要是把FLASH晶圆固定在钢板框架上,然后通过打线把晶圆上的点连接到框架的PIN脚上,再对表面进行注胶。
目前的最高的封闭技术能把四颗晶圆封闭在一个TSOP 的FLASH内。此种TSOP封装的FLASH相对较厚。TSOP特点:电流大幅度变化时,引起输出电压较小,适合高频应用,操作比较方便(如方便手工贴片或拆片及反复利用),可靠性也比较高。同时TSOP封装具有成品率高。价格相对COB高,因此得到了极为广泛的应用。
2.COB封装
COB(chip on board) 板上芯片封装,是裸芯片贴装技术之一。半导体芯片交接贴装在印刷线路板上,芯片与PCB板是通过邦定连接的方法实现。NAND FLASH行业使用COB的封装方式主要是节省成本考虑。工程师先把外围电气走线画好,然后在PCB板上点红胶,把晶圆按指定方向及位置贴好。
然后使用邦定机对晶圆进行邦定。确认邦定电气性能良好后,对晶圆表面及PCB板部分进行树脂覆盖固定。COB 是最简单的裸芯片贴装技术,但它的封装密度远不如TSOP和BGA技术。
3.BGA封装
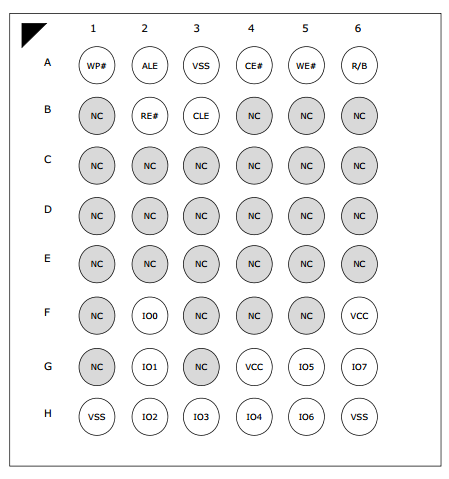
BGA(ball grid array) 球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以 代替引脚,在印刷基板的正面装配NANDflash 芯片,然后用模压树脂或灌封方法进行密封。封装本体也可做的比QFP(四侧引脚扁平封装)小。
BGA主要特点:1、I/O引脚数虽然增多,但引脚之间的距离远大于QFP封装方式,提高了成品率 2、虽然BGA的功耗增加,但由于采用的是可控塌陷芯片法焊接,从而可以改善电热性能 3、信号传输延迟小,适应频率大大提高 4、组装可用共面焊接,可靠性大大提高。此封闭应用在NAND FLASH方面,主要影响是:1、可针对一些大尺寸晶圆进行封装。2、减小NAND flash封装片的面积,适用于对于主板尺寸要求严格的产品,特别是近些年来的可穿戴设备,对于产品尺寸的要求相当严格。3、此封闭大部分为原装片使用。黑片相对较少使用BGA。
从上面可以看出BGA的封装是比较适合小型化需求的,以韩国ATO solution公司为例,1Gb容量的NAND flash,BGA的最小尺寸可以做到6.5 X 8 mm (48ball),普通的1Gb NAND flash的尺寸为9 X 9 mm(48ball)。对于产品空间要求比较苛刻的客户可以选择。
有兴趣的伙伴,欢迎联系我们。

